走査型容量顕微鏡 (SCM) / 走査型広がり抵抗顕微鏡 (SSRM)
原理概要
走査型容量顕微鏡(SCM)は、導電性AFM探針を試料表面に接触させた状態で、探針と試料間に交流電圧を印加し、
表面近傍に形成される空乏層の変調に伴う微小な静電容量変化(dC/dV)を検出する手法です。この容量変化は
キャリア濃度や導電型(p/n)に依存するため、SCMではキャリア極性の判別や相対的なドーピング分布を
ナノメートルスケールで評価できます。すなわち、SCMは「電気的応答(容量変調)を通してキャリア情報を
間接的に見る手法」です。
走査型広がり抵抗顕微鏡(SSRM)は、導電性AFM探針を試料断面に強く接触させ、探針と試料間に直流電圧を
印加して流れる電流を測定し、局所的な広がり抵抗(spreading resistance)を求める手法です。この抵抗値は
キャリア濃度に強く依存するため、SSRMではキャリア濃度に対応した局所抵抗分布を高空間分解能で取得できます。
すなわち、SSRMは「電流の流れやすさ(抵抗)を直接測定してキャリア濃度を評価する手法」です。
原理イメージ図
SCM SSRM
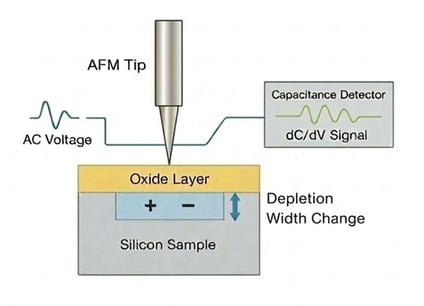

応用例
SCM
・pn接合およびドーピング極性の可視化
・MOS構造の電気特性評価
・低濃度ドーピング領域の評価
・酸化膜/絶縁膜界面評価
・ナノデバイスの電気的不均一評価
SSRM
・高濃度ドーピング領域の評価
・絶対キャリア濃度プロファイル測定(ただし、標準試料が必要です)
・リークパス・導電異常解析
・ワイドバンドギャップ半導体(SiC、酸化ガリウム等)の評価
・接触抵抗・界面導電性評価
特徴と欠点
SCM
<特徴> <制限と欠点>
| 1. | n型/p型のドーピング極性を判別できる | 1. | 濃度の絶対値評価が困難(相対評価は可) | ||
| 2. | pn接合位置を高分解能で可視化できる | 2. | 高濃度領域では信号が飽和しやすい | ||
| 3. | 低ドーピング領域に高感度 | 3. | 表面状態や酸化膜の影響を受けやすい | ||
| 4. | 界面電荷や電気状態の評価が可能 | 4. | 電流経路やリーク解析には不向き |
SSRM
<特徴> <制限と欠点>
| 1. | キャリア濃度の定量評価が可能 | 1. | ドーピング極性の判別ができない | ||
| 2. | 高濃度ドーピング領域の測定に強い | 2. | 低濃度領域では感度が低い | ||
| 3. | リークパスや導電異常を直接可視化できる | 3. | 探針接触による試料損傷が生じやすい | ||
| 4. | ワイドバンドギャップ材料にも適用可能 |
4. | 断面研磨品質に測定結果が影響受けやすい |
ご依頼時の留意点
SCM・SSRM共通
<試料基本情報>
▸試料サイズ:数mm~数cm程度(AFMステージに搭載可能なサイズ)
▸試料厚さ:数百µm~数mm 程度が望ましいです。
▸表面状態:平坦で清浄な表面
▸断面観察の場合 :断面研磨が必要です。
<ご提供いただきたい情報>
▸測定目的(例:ドーピング分布確認、pn接合位置特定、不良解析など)
▸試料構造情報(基板材料、膜構成、デバイス構造)
▸測定位置、断面形状、測定視野
▸ドーピング元素および極性(n型/p型)
▸予想されるキャリア濃度範囲


