二次イオン質量分析(SIMS)
原理概要
数keV~数10keVエネルギーを持ったイオン(一次イオン)を固体表面に照射した際に生じるスパッタリングを応用した
分析手法です。スパッタリングにより放出された粒子中に含まれるイオンを二次イオンと呼び、この二次イオンを質量分離、検出することで固体表面に含まれる不純物の同定と濃度を測定します。また、スパッタリングを連続的に行うことで深さ方向の分布を測定できます。
原理イメージ図
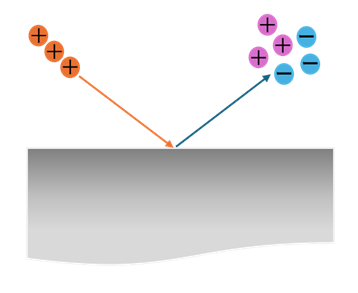
応用例
・各種半導体材料中のドーパントや不純物の深さ方向濃度分析
・III-V半導体の組成深さ方向濃度分析
・ガラス中の不純物濃度分布測定
・High-k膜/Low-k膜中の組成分布や不純物濃度分析
・GaNエピタキシャル膜中のMg, C, Si不純物深さ方向濃度分析
・金属膜中の不純物深さ方向分析
・宝石や鉱物中の不純物分布分析
特徴と欠点
<特徴>
1. 高感度: ppm から pptの検出下限
2. 検出濃度範囲が広い: マトリックス元素から極微量不純物まで
3. 標準試料を用いて定量分析可能
4. 全元素の検出が可能: H を含む全元素
5. 同位体の測定が可能
6. 良い深さ方向分解能: 1nm~3nm (ベストな場合)
7. 測定できる膜厚範囲が広い: 数nmから 数10μmまで
<欠点>
1. マトリックス効果
・元素の感度差が大きい(5桁以上)
・データ解釈を複雑にする要因
2. 同時に測定できる元素に限界
3. 定量には標準試料が必要
・特に金属試料に関しては標準試料が少ない
4. 試料形状や表面状態に影響を受けやすい
ご依頼時の留意点
<試料基本情報 >
▸試料サイズ: 5mmx6mm角以上10mmx10mm程度、厚さは1~2mm厚程度
※大きいもの、厚いものについては、切断やトリミングが必要になる場合があります。
▸表面状態: できるだけ平らが望ましいです。
<ご提供いただきたい情報>
▸試料構造の情報(膜構成や基板の情報)
▸予測される膜厚や濃度など
▸試料の導電性情報
<試料送付方法>
▸チップケース、ウエハケース、薬包紙、アルミ箔などを利用してお送りください。
(輸送中の割れと表面へのパーティクルの発生にご注意ください)
▸ケースに入れる際にはケース内で動かないような工夫が必要です。
→パーティクルの抑制(特に表面付近のH, C, O, Siなどの測定時に重要です)
▸試料番号、IDの記載(裏面やケース上に記載ください)
→パーティクル抑制のため、表面の端にケガキを入れることも有効です。


